平面磁控溅射靶是现代真空镀膜设备的核心部件,以其结构相对简单、加工便捷、性能稳定而成为工业界与科研领域应用最广泛的溅射源。它通过引入磁场巧妙地控制带电粒子的运动,从根本上提升了溅射效率。根据靶材的平面形状,主要可分为圆形平面磁控溅射靶和矩形平面磁控溅射靶。两者在核心工作原理上完全一致,仅在结构形态上有所区别,以适应不同形状基片的镀膜需求。
一、 核心结构与功能组件
一个完整的平面磁控溅射靶是一个集电、磁、热管理于一体的精密系统,主要由以下几个关键部分构成:
1. 靶材:作为镀膜材料的来源,通常是厚度为3~10mm的平板。它被紧密地固定在阴极体上,通常通过螺钉或高温钎焊的方式,以确保良好的机械连接和导热性能。
2. 磁体系统:这是磁控溅射的“灵魂”。在靶材的背面,布置有永久磁铁(如钕铁硼)或电磁线圈,或二者的复合结构。其核心作用是在靶材表面附近的空间内,形成一个特定形态的静态磁场。
Ø对于圆形靶,该磁场是以其轴线为对称轴的环状场。
Ø对于矩形靶,则形成一条封闭的环形跑道状磁场。
3. 极靴(轭铁):由纯铁、低碳钢等高导磁材料制造。它的作用如同电路的“导线”,能够高效地引导和集中磁力线,使靶面的磁场分布更加强烈和规整。一个设计优良的极靴是获得高溅射速率和宽泛刻蚀区域的关键。
4. 水冷系统:由于溅射过程中靶材会承受高能离子的持续轰击而产生大量热量,必须进行有效冷却。水冷通道(直接通入靶背或通过铜靶座间接冷却)负责将热量带走,严格控制靶材温度。温度控制至关重要:温度过高可能导致靶材熔化(对于低熔点金属)或引起合金靶材表面成分偏析,破坏镀膜成分;温度过低则会使溅射速率下降。
5. 屏蔽罩:安装在靶材周围,其首要功能是防止阴极体等非靶材部件被溅射,从而保证薄膜的纯度。其次,接地的屏蔽罩还能作为辅助阳极,有效地吸收那些最终逃逸出磁场约束的低能电子,有助于维持放电的稳定性。

二、 工作原理:磁场的约束效应
平面磁控溅射的工作机制,可以概括为一场对电子的“精妙囚禁”。
在溅射靶上施加500~600V的直流负高压,真空室壁(阳极)接地。当通入适量氩气(工作气压通常约0.1Pa)并激发放电后,靶面在离子轰击下会释放出大量的二次电子。在普通二极溅射中,这些电子会直线飞向阳极,路径很短,电离效率低。
而在磁控溅射中,靶面附近的磁场与电场方向正交。根据物理学原理,带电粒子在正交的电磁场中会作漂移运动。磁场的作用就像一道无形的“牢笼”,将这些二次电子紧紧地束缚在靶面附近,迫使它们沿着磁力线方向进行螺旋式的长路径运动。
这种“电子囚禁”带来了两大革命性好处:
1. 极高的电离效率:电子运动轨迹被极大延长,使其与氩气原子发生碰撞电离的几率呈指数级增加,从而产生并维持了异常高密度的等离子体。
2. 低气压、低电压工作:正因为电离效率高,磁控溅射不再需要高气压和高电压来维持放电。它可以在低气压(0.13~1.3Pa) 和低靶电压(300~700V) 下稳定运行,这不仅降低了薄膜中掺入杂质气体的风险,也减少了对已沉积薄膜的高能粒子轰击损伤。
最终,被高密度等离子体加速的高能Ar⁺离子持续轰击靶材,溅射出的靶材原子飞向基片,沉积成膜。

三、 圆形与矩形靶的磁场与刻蚀特性
1. 圆形平面靶:其磁场呈轴对称环状。因此,等离子体被集中在这个环状区域上方,导致靶材的刻蚀也集中于此,形成一个逐渐加深的环形沟道(常称“跑道区”)。一旦沟道被刻穿,即使靶材其余部分还很厚,整个靶也必须更换,这导致其靶材利用率较低,通常仅为30%左右。
2. 矩形平面靶:其磁场构成一个封闭的环形跑道。磁力线从跑道外侧穿出靶面,再从内侧进入。为了实现大面积均匀镀膜,矩形靶的磁路设计尤为关键。工业上常采用小块永磁体拼接的方式构成磁路,这样可以根据实际镀膜的均匀性反馈和靶材刻蚀的深浅分布,灵活地调整局部磁铁的排布与方向,从而优化磁场分布,改善膜厚均匀性。
无论形状如何,靶面磁场水平分量的强度都需要精确控制在一个最佳范围内(圆形靶通常为0.02~0.06T,矩形靶为0.03~0.08T),过强或过弱都会影响放电效率和稳定性。
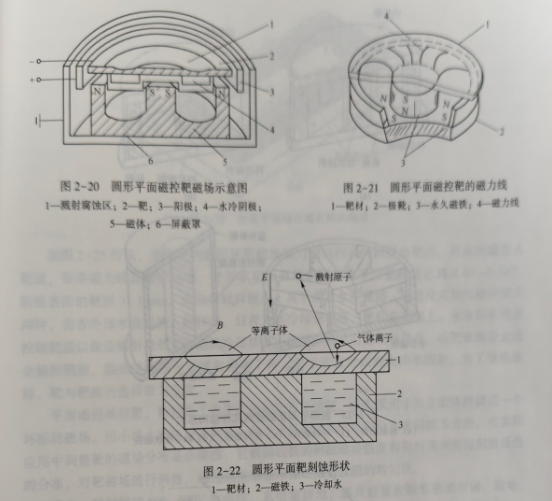
四、 典型工艺参数与放电特性
平面磁控溅射的典型工艺窗口体现了其高效、温和的特点:
v工作压强:0.1 Pa (范围 0.13 ~ 1.3 Pa)
v靶电压:300 ~ 700 V
v靶电流密度:4 ~ 60 mA/cm²
v靶功率密度:1 ~ 36 W/cm² (高功率应用可达136 W/cm²甚至更高)
其放电特性服从经验公式:I = KUⁿ。其中,I为放电电流,U为靶电压,K是与装置和气压相关的常数,n是表征等离子体约束效率的关键系数(n值通常大于1,值越大表明电子束缚效应越好,放电效率越高)。相应的功率公式为 P = I * U = K Uⁿ⁺¹。在恒定电流下,靶电压与气压呈负相关关系,即气压升高,维持同样电流所需的电压会降低。

五、 技术优势与核心挑战
显著优势:
Ø高沉积速率:得益于高密度等离子体,其沉积速率远高于传统二极溅射。
Ø低基片温升:高效率和低气压工作,使传递到基片的热量减少,适用于对温度敏感的基材。
Ø薄膜质量高:低气压减少了薄膜中夹杂的气体分子,薄膜更致密,纯度更高。低电压则减轻了高能粒子对薄膜的轰击损伤。
Ø工艺窗口宽,易于控制:通过独立调节功率、气压等参数,可以精确控制薄膜的沉积速率和性质。
核心挑战:
其最突出的缺点是靶材利用率低。由于刻蚀仅集中在一个狭窄的环形跑道区,大部分靶材未被有效利用,造成了材料的浪费,这是磁控溅射技术本身固有的现象,也是当前技术改进的主要方向之一(如采用旋转圆柱靶等结构)。
总结:平面磁控溅射技术通过引入磁场约束电子,巧妙地解决了传统二极溅射效率低、工作条件苛刻的难题,实现了在低温、低损伤条件下的高质量、高速率薄膜沉积。尽管存在靶材利用率低的不足,但其卓越的综合性能使其在微电子、光学镀膜、装饰涂层、工具硬化等众多领域持续发挥着不可替代的作用。


 客服1
客服1